기계연-프로텍 공동 연구 끝에 'Gang-Bonder' 장비 개발
반도체 분야서 '대량 동시 조립' 화두···국내 연구진이 첫 구현
"특수기체 이용해 칩 접촉 않고 압력 인가···가장 앞선 기술"

한국기계연구원(원장 박상진)은 송준엽 첨단생산장비연구부 초정밀장비연구실팀이 반도체 장비 제조 전문업체 프로텍과 갱-본더(Gang-Bonder) 장비를 개발했다고 11일 밝혔다.
갱-본더 기술은 기존의 반도체 칩을 기판에 하나씩 조립하던 방식과 달리 여러 개의 칩을 동시에 조립하는 기술이다. 반도체 조립 공정 분야에선 대다수 연구자들이 구현하고 싶은 연구 주제였으나, 기술 수준이 높아 그동안 난제로 남았다.
기계연 연구팀은 반도체 칩을 대량 조립하기 위해 열과 압력을 핵심으로 봤다. 반도체처럼 초정밀 공정에선 미세한 온도와 압력 차이에 따라 칩 정렬의 오차가 생긴다. 반도체 칩마다 두께와 기판의 편차가 있기 때문에 각각 다른 열과 압력을 인가해야 한계가 있었다.
연구팀은 갱-본더 방식의 패키징을 구현하기 위해 특수 기체를 이용해 칩과 접촉하지 않고 압력을 인가하는 기술을 개발했다. 이 방식을 활용하면 칩 또는 기판의 두께 편차가 발생하더라도 균일한 압력을 가할 수 있다. 칩의 정렬이 틀어지는 조립 오차 문제도 해결했다.
여기에 균일한 열전달이 가능한 기술도 구현이 가능해질 전망이다. 연구팀은 300mmX300mm 이상 대면적을 초당 20도 이상을 올렸다 낮췄다를 반복할 수 있는 셀 세라믹 히터를 개발했다. 이 기술을 적용하면 기존에 대면적을 한 번에 가열하면서 생기는 열충격에 의한 히터 파손 문제를 해결할 수 있다. 생산 공정의 속도는 높이고 불량은 줄일 수 있는 기술이다.
송준엽 기계연 박사는 "이번에 개발한 갱-본더 반도체 조립 장비는 유럽, 일본 등 반도체 분야 선도국가가 주도하는 사양보다 앞선 기술"이라면서 "반도체 웨이퍼와 패널 레벨 패키지 초정밀 조립 분야에 활용될 수 있어 관련 산업의 고속 성장에 기여할 수 있을 것"이라고 언급했다.
해당 기술을 적용할 수 있는 분야는 다양하다. AI 반도체 패키지부터 웨어러블 디바이스, 스마트카드, 메디컬 디바이스, 마이크로-LED(Micro-LED) 디스플레이 등이 있다. 연구팀에 따르면 상용화가 이뤄지기 위해선 현장 공정에서 기술 검증이 뒤따라야 한다고 밝혔다. 이미 삼성전자와 SK하이닉스에서 이 기술을 눈독 들이는 것으로 알려졌다.
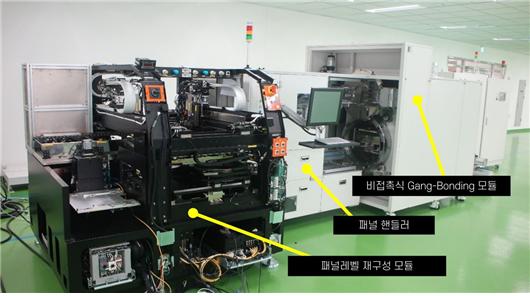
댓글 정렬