표준연, 나노미터급 산화막 절대 두께 측정법 완성
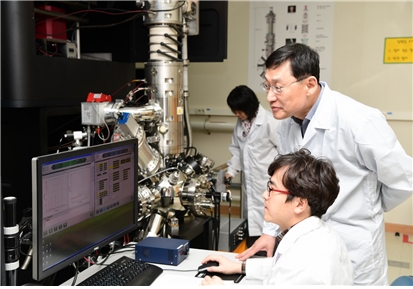
한국표준과학연구원(원장 박상열)은 김경중 나노구조측정센터 박사팀이 중에너지이온산란분광기(MEIS)를 이용, 나노미터(nm)급 산화막의 절대 두께를 측정할 수 있는 상호보정법을 완성했다고 23일 밝혔다. 절대 두께는 다른 요소에 영향을 받지 않는 실제 두께를 말한다.
반도체 공정에서 집적회로를 만드는데 사용하는 웨이퍼는 표면에 얇고 균일한 산화막을 형성하는 것이 중요하다. 산화막은 웨이퍼 표면을 보호함과 동시에 전류의 흐름을 제어하는 역할을 하며, 산화막이 형성된 웨이퍼 위에 반도체 설계회로가 그려진다. 산화막 두께를 유지하고 정확히 측정하는 것은 반도체의 수율을 결정짓는 핵심 요인으로 꼽힌다.
지금까지 반도체 공정에서는 투과전자현미경(TEM), 분광타원계측기(SE), 엑스선반사측정기(XRR) 등으로 산화막 두께를 측정했다. 문제는 이렇게 측정한 산화막의 두께가 실제 두께와 큰 차이를 보였다는 것이다. 장비 사용이 어렵고 품질 확보에도 불확실성이 생겨 산화막 측정은 반도체 소자 제작에서 커다란 근심거리로 남아있었다.
김경중 박사팀은 10년 이상 연구 끝에 완벽한 산화막 절대두께 측정기술을 완성했다. 상호보정법은 2가지 방법을 사용해 측정결과의 정확도를 높이는 기술이다.
연구팀은 이번 기술에 국내 중소기업의 MEIS 장비를 활용했다. 재현성이 좋은 MEIS로 산화막 두께를 측정한 다음, 길이 단위의 소급성을 갖는 TEM의 측정 결과로 보정한 것이다.
이번 성과는 이미 검증된 측정결과와의 비교를 통해 그 우수성이 입증됐다. 국제도량형위원회(CIPM) 물질량자문위원회(CCQM)가 주관하는 세계 측정표준기관들의 공동연구에서 결정된 하프늄산화막(HfO2)의 두께와 연구팀이 측정한 두께를 비교한 결과, 1% 수준의 차이에서 정확하게 일치하는 것을 확인했다.
김경중 박사는 "일본의 수출규제 등으로 인한 경제 위기 상황에서 반도체 소재 개발을 위해 국가측정표준기관이 나선 좋은 사례"라며 "중소기업과의 협력으로 탄생한 이번 기술은 반도체 산업 현장에 활용되어 차세대 반도체 소자의 생산 수율을 크게 향상시킬 것"이라고 말했다.
연구결과는 측정과학분야의 세계적 학술지인 메트롤로지아에 온라인 게재됐다. 국가표준기술력향상사업을 통해 ISO 국제표준으로 제정될 예정이다.
댓글 정렬